新品發布 | AI重構數據中心,GPU散熱如何破局?
繼OpenAI公司推出ChatGPT之后,DeepSeek-V3和R1兩款大模型再度在海內外引發轟動,AI技術創新和普惠應用邁入新階段。隨著AI應用的蓬勃發展,其算力底座數據中心面臨全新挑戰,以滿足智算發展需求。數據中心架構正加速向高密度、智能化和可持續方向演進。作為其中的“高性能引擎”,AI服務器以其異構計算架構、分布式擴展等特性為智算提供了有力支撐,但更高的功率密度使得其搭載的GPU芯片等核心硬件的散熱問題愈發嚴峻。高可靠、高性能的散熱解決方案已成為核心需求。

當前,芯片散熱主要考慮外部系統散熱技術和導熱界面材料兩個方面。從外部系統來看,在功率密度上升和節能目標的雙重倒逼下,AI發展正加速推動液冷技術代替傳統風冷成為制冷系統主流。其中,單板式液冷因節能優勢更突出、技術更成熟,在液冷數據中心的應用達90%以上。從導熱界面材料來看,技術快速更新的應用場景則對導熱界面材料提出了更嚴苛更全面的要求。
挑戰一
GPU在高性能計算中會產生大量熱量,尤其是在深度學習、圖像處理等任務中熱量密度極高。其散熱設計功耗已超過800W,傳統有機硅體系的導熱材料難以滿足需求。
挑戰二
冷板式液冷等制冷系統帶來了更高的散熱效能,界面熱傳導效率則是決定性的“最后一毫米”戰場。在AI服務器等0.1mm以下的低BLT應用場景,需要導熱界面材料具備更低的熱阻和優異的填隙能力以進一步提高熱傳導效率。
挑戰三
既要“薄”,也要“穩”。隨著芯片尺寸擴展、單卡功率增高,熱應力翹曲呈增大趨勢,加之數據中心不間斷運行的長期高溫環境,需要導熱界面材料具備優異的的長期可靠性,以解決日益突出的老化變干、pump out等問題。

芯片翹曲擠壓導熱界面材料,材料內聚力不足產生pump out
針對這一工況,泰吉諾創新研發超薄導熱界面材料Fill-TPM 800,專為大功率大尺寸場景帶來越來越大的翹曲問題提供高可靠的TIM1.5導熱解決方案。Fill-TPM 800可在-40℃至125℃寬幅溫度區間實現超薄填充貼合、高效精準導熱,同時具有極低的熱阻,特別適用于算力芯片、IGBT模組等應用場景,在風冷、冷板式液冷等制冷系統的裝配壓力下,均有著優異的導熱性能表現。基于獨特的配方設計,Fill-TPM 800進一步強化長期可靠性,更高的內聚力可有效防止因大尺寸芯片翹曲及面內發熱不均所產生的pump out現象。

產品特點
極低熱阻,滿足增長的散熱需求
低BLT應用中,界面熱阻比起導熱系數對散熱效率有著更大的影響。
Fill-TPM 800隨溫度的升高逐漸變軟,在較低壓力下可達到低BLT,并充分填充界面間隙,有效降低界面熱阻。在40psi下,Fill-TPM 800對比目前主流的高可靠性導熱材料石墨烯,具有明顯的熱阻優勢,極低熱阻媲美高性能相變化材料與高端硅脂材料。

更高內聚力,強化長期可靠性
Fill-TPM 800采用非硅系基材,無硅污染。獨特配方設計使其具有更高的內聚力及自修復能力,應對日益嚴峻的老化變干、pump out等可靠性問題。與同樣適用于超薄界面、有著極低熱阻的相變化材料、硅脂相比,Fill-TPM 800優異的內聚力使其在長期表現上更為可靠。

柔韌自粘片材,易于操作和重工
Fill-TPM 800在室溫下具有柔軟的特性和表面自粘性,使其具有良好的施工性能和重工性,可以直接定位并粘貼在散熱器或芯片表面。可根據客戶需求,提供卷材、片材或者是裁切好的各種形狀及尺寸,以滿足不同應用需求。



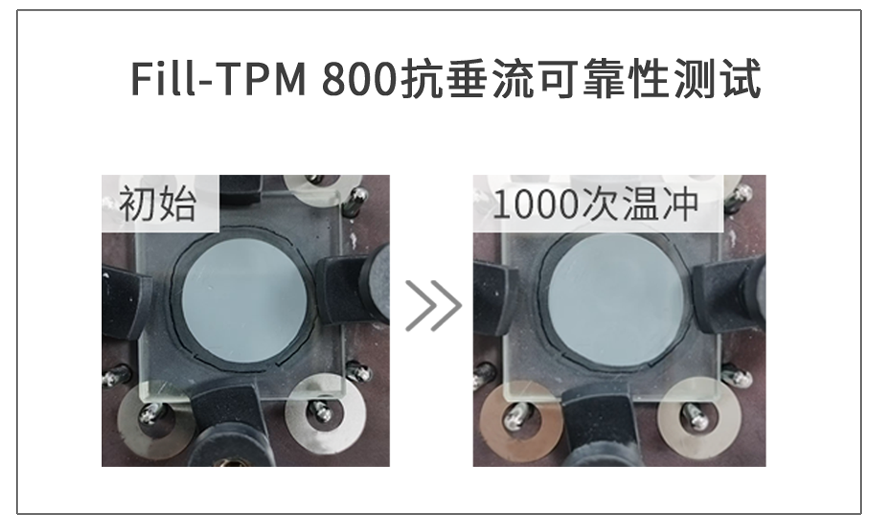
Fill-TPM 800在整個可靠性測試過程中熱阻表現穩定, 在持續高溫,高低溫沖擊以及雙85測試條件下,Fill-TPM 800均能夠保持其初始的熱性能,沒有出現導熱性能下降的跡象。在抗垂流可靠性測試中,經-40℃~+125℃溫沖1000次后,Fill-TPM 800沒有出現開裂或下滑的情況,表現出了優異的抗下滑能力。
伴隨著AI技術的飛速發展,AI算力系統所面臨的散熱挑戰正加速升級。在液冷技術驅動外部系統革新的同時,導熱界面材料端亟需更高性能的解決方案。泰吉諾Fill-TPM 800為冷板式液冷及風冷系統帶來了全新高性能導熱解決方案;針對噴淋式、浸沒式,冷卻液與發熱器件直接接觸的場景,泰吉諾全面的液態金屬產品矩陣則帶來了多樣化選擇。未來,泰吉諾將在高效散熱、可靠性、環保性等方面持續突破,以創新導熱界面材料為智算發展注入強勁動力,助力全球智能化進程。










